中国科大在垂直型GaN功率晶体管研究方向取得重要进展
半导体产业网获悉:中国科技大学微电子学院杨树教授和龙世兵教授课题组在垂直型GaN功率晶体管研究方向取得进展,实现了具有高反型沟道迁移率的垂直型GaN沟槽栅MISFET,相关研究成果以“Achieving 205 cm2V-1s-1 Inversion Channel Mobility in 1.4 kV Vertical GaN-on-GaN MISFET With Nitride Gate Dielectric”为题在2024 IEEE International Electron Devices Meeting (IEDM)上做口头报告。
千伏级功率器件在光伏、工业电机、电动汽车、医疗供电等领域具有广阔应用前景。垂直型GaN-on-GaN功率器件能够拓展传统GaN器件的电压和功率等级,并具有优异的散热和动态性能。当前,在多数1.2~1.7 kV宽禁带半导体沟槽栅MOSFETs中,因反型沟道迁移率难以提升,沟道电阻通常占器件整体导通电阻的~30%或以上。为了降低器件导通电阻和损耗、提升功率转换效率,需要探索功率MOSFET中反型沟道迁移率的有效提升方法。
研究团队通过优化栅槽刻蚀工艺,实现了低粗糙度、清洁光滑无微沟槽的栅极沟槽,可抑制表面粗糙度散射;同时在栅介质沉积系统中原位生长高质量AlN界面插入层,可将界面陷阱密度降低约一个数量级,可抑制库仑散射。器件结构示意图及沟槽栅MIS界面如图1所示。
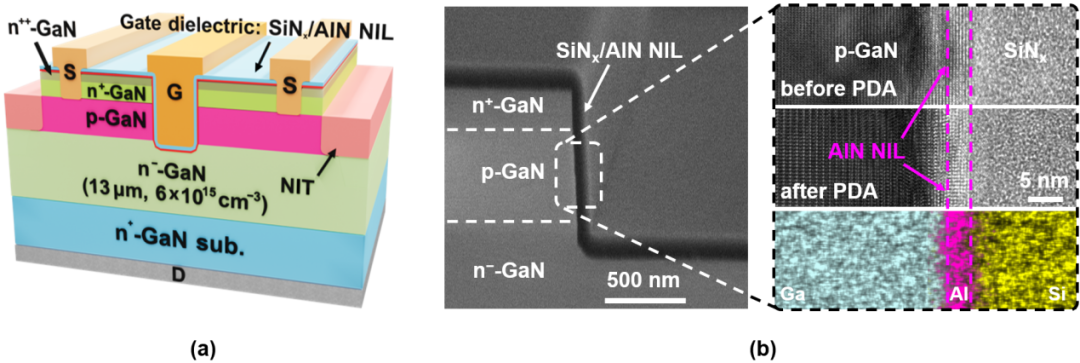
图1. 具有AlN界面插入层的垂直型GaN-on-GaN沟槽栅MISFET:(a) 器件结构示意图;(b) 器件栅槽处SEM、TEM及EDS表征结果。
具有AlN界面插入层的垂直型GaN功率MISFET导通电阻~2.0 mΩ·cm2,阈值电压~4.1V,电流摆幅~1010,击穿电压~1.4 kV。通过AlN界面插入层对沟道载流子散射机制的抑制,无需复杂再生长工艺,即可将沟槽栅反型沟道迁移率从30 cm2/V·s提升至205 cm2/V·s,在当前国际报道的千伏级同类器件中较为领先。器件导通特性和沟道迁移率提取结果如图2所示。
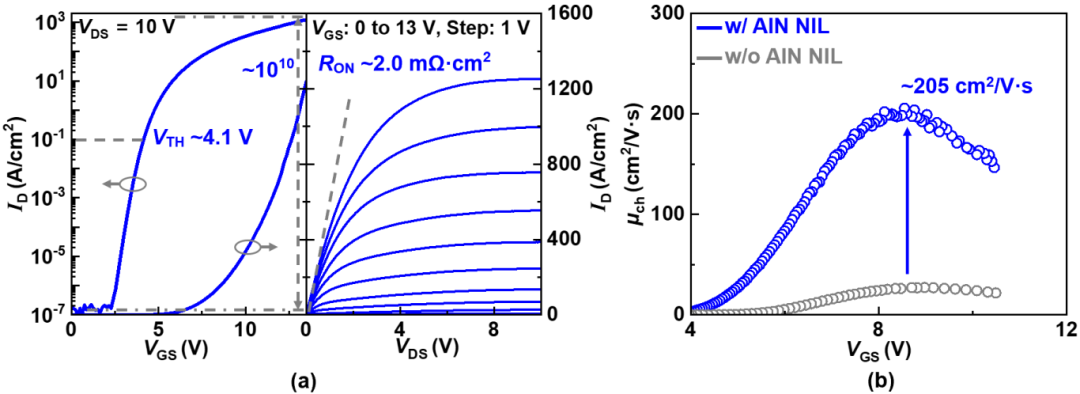
图2. 具有AlN界面插入层的垂直型GaN-on-GaN沟槽栅MISFET:(a) 导通特性;(b) 反型沟道迁移率提取结果。
中国科技大学微电子学院博士生韩在天为论文第一作者,杨树教授为论文通讯作者,龙世兵教授为合作教授。该研究工作得到了国家重点研发计划、国家自然科学基金等项目的资助。
免责声明:本文由第三代半导体产业根据公开信息整理或转发,仅为分享与讨论,不代表我方赞成或认同,如有异议,侵权请联系我们删除! ]article_adlist-->

重要通知:2025年4月23-25日,2025九峰山论坛暨化合物半导体产业博览会将在武汉光谷科技会展中心再次启航,首次超过2万平方米,拟邀展商数量超过300家,规模创新高!聚焦变革前沿,本届展会精心打造功率器件展区,汇聚产业链上下游优质厂商,集中展示行业最新技术成果和解决方案,推动功率器件在新能源汽车、智能电网、可再生能源等领域的深化应用,探索行业破局之路。现诚挚邀请全球化合物半导体技术领域的专家学者、行业领航者及创新先锋莅临盛会,发表精彩演讲!目前招展火热进行中,好位置先到先得!~点击上图了解详情

(转自:第三代半导体产业)
 海量资讯、精准解读,尽在新浪财经APP
海量资讯、精准解读,尽在新浪财经APP
